基本案例仿真 金属-半导体接触(MS)
金属-半导体接触(MS)在直流、微波应用以及组成其它半导体器件方面十分重要,广泛应用于光电探测器、太阳电池、MESFET栅电极的制作。根据金属和半导体功函数的关系,金半接触可以形成阻挡层和反阻挡层两种情况,对于一块n掺杂的半导体,当金属功函数大于半导体时,交界面处将形成阻挡层;当金属功函数小于半导体时,将形成反阻挡层。我们将展示 Nuwa TCAD工具对金属-半导体接触(MS)的仿真,讨论形成阻挡层和反阻挡层时的电流电压特性。
一、材料参数
1 基本参数
| 材料名称 | 硅(Si) | 铝(Al) | 镁(Mg) |
|---|---|---|---|
| 禁带宽度/eV | 1.166-4.73×10-4•T2/(T+636.0) | N/A | N/A |
| 相对介电常数 | 11.9 | N/A | N/A |
| 亲和势/eV | 4.05 | 4.3 | 3.7 |
| 电子有效质量/m0 | 0.3165+1.3628×10-4•T | N/A | N/A |
| 空穴有效质量/m0 | 0.523+1.4×10^-3•T-1.48×10-6•T2 | N/A | N/A |
| 电阻率/Ω·m | N/A | 2.74×10-8 | 4.3×10-8 |
默认温度 T=300K
2 模型
1.Mobility Model Low Field:Analytic Low-Field Mobility Model
| symbol | parameter name | electron value | Hole value | units |
|---|---|---|---|---|
| μ1 | mu1 | 0.005524 | 0.00497 | m2/(V*s) |
| μ2 | mu2 | 0.142923 | 0.047937 | m2/(V*s) |
| α | alpha | 0.0 | 0.0 | N/A |
| β | beta | -2.3 | -2.2 | N/A |
| γ | gamma | -3.8 | -3.7 | N/A |
| 𝛿 | delta | 0.73 | 0.70 | N/A |
| Ncrit | Ncrit | 1.072×1023 | 1.606×1023 | m-3 |
High Field:Canali Model
| symbol | parameter name | electron value | Hole value | units |
|---|---|---|---|---|
| β0 | beta0 | 1.109 | 1.213 | N/A |
| βexp | betaexp | 0.66 | 0.17 | N/A |
| α | alpha | 2.4×105 | 2.4×105 | m/s |
| θ | theta | 0.8 | 0.8 | N/A |
| Tnom | Tnom | 600 | 600 | K |
2.Carrier Statistics:Fermi-Dirac distributions
3.Incomplete Ionization Model
二、结构建立
由于铝(Al)的功函数(即亲和势)为4.3eV,大于一块n掺杂硅(Si)的功函数,因此在金半接触时会形成阻挡层;镁(Mg)的功函数(即亲和势)为3.7eV,小于一块n掺杂硅(Si)的功函数,因此会形成反阻挡层。
1 基底与工艺选择
基底材料:硅(Si)
工艺:
步骤1 对硅(Si)进行n掺杂,掺杂浓度为1×1017cm-3
步骤2 在基底硅(Si)上沉积一层铝(Al)/镁(Mg)
2 电极
铝(Al)/镁(Mg)外接欧姆电极:anode 硅(Si)外接欧姆电极: cathode
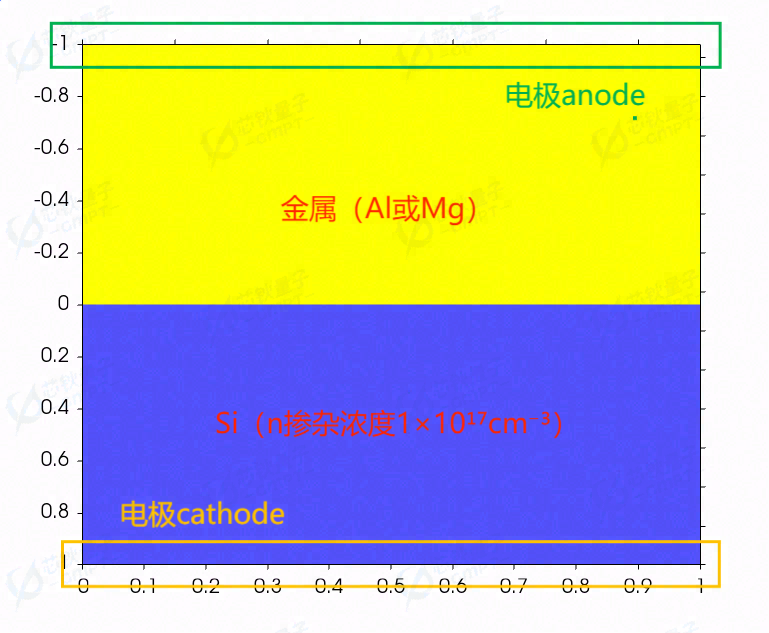
三、平衡态求解
电极anode、电极cathode电压均为0V
四、非平衡态求解
电极cathode电压保持0V,电极anode电压由-3V增加至5V
五、仿真结果及物理正确性的分析
1 基本物理量分布
n掺杂浓度为1×1017cm-3的Si的功函数约为4.2eV,因此和功函数为4.3eV的Al接触时,交界面附近能带向上弯曲,电子从半导体一侧向金属运动时存在势垒阻碍,称为阻挡层;和功函数为3.7eV的Mg接触时,交界面附近半导体能带向下弯曲,电子浓度变大,电子从半导体向金属运动相对容易,称为反阻挡层。阻挡层和反阻挡层情况平衡态下的能带图如下:
 |  |
| Si-Al阻挡层平衡态能带图 | Si-Mg反阻挡层平衡态能带图 |
2 特性曲线
阻挡层情况 对于阻挡层情况,外加正向偏压下,半导体一侧势垒高度降低,电子更容易从半导体一侧向Al运动,因此电流随正向偏压的增大而增大;外加反向偏压下,半导体一侧势垒高度增加,而金属一侧的势垒高度不变,少量电子从金属向半导体运动,因此反向电流非常小。阻挡层情况的电流电压特性曲线如下:
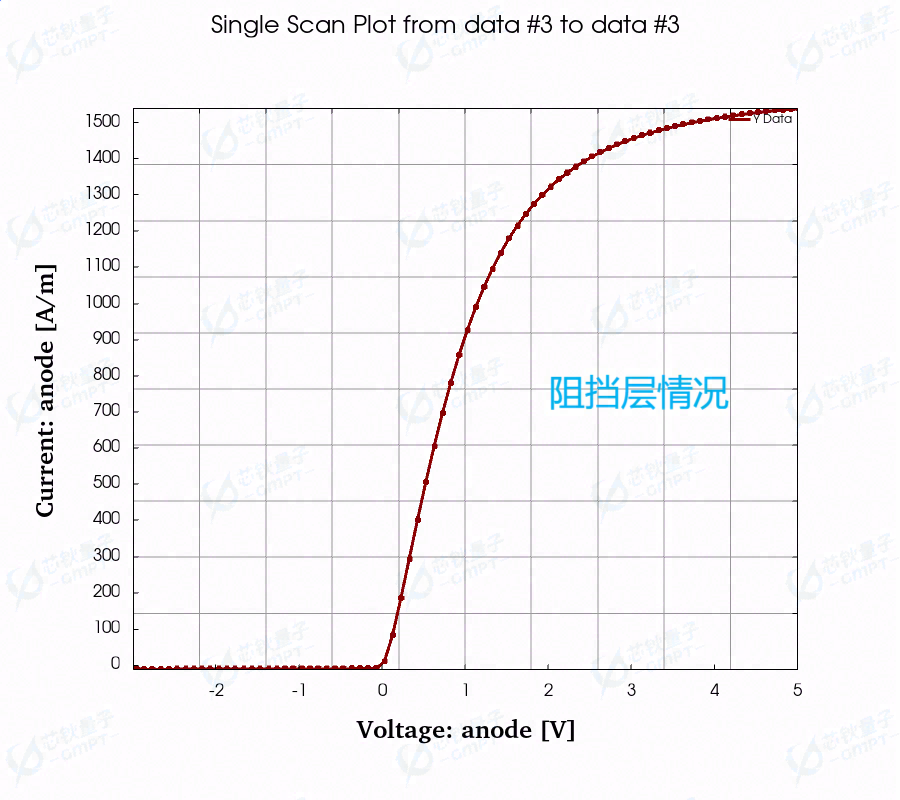
反阻挡层情况 对于反阻挡层情况,由于半导体和金属的交界面处电子浓度大,所以在外加电压下表现出欧姆特性。反阻挡层情况的电流电压特性曲线如下:
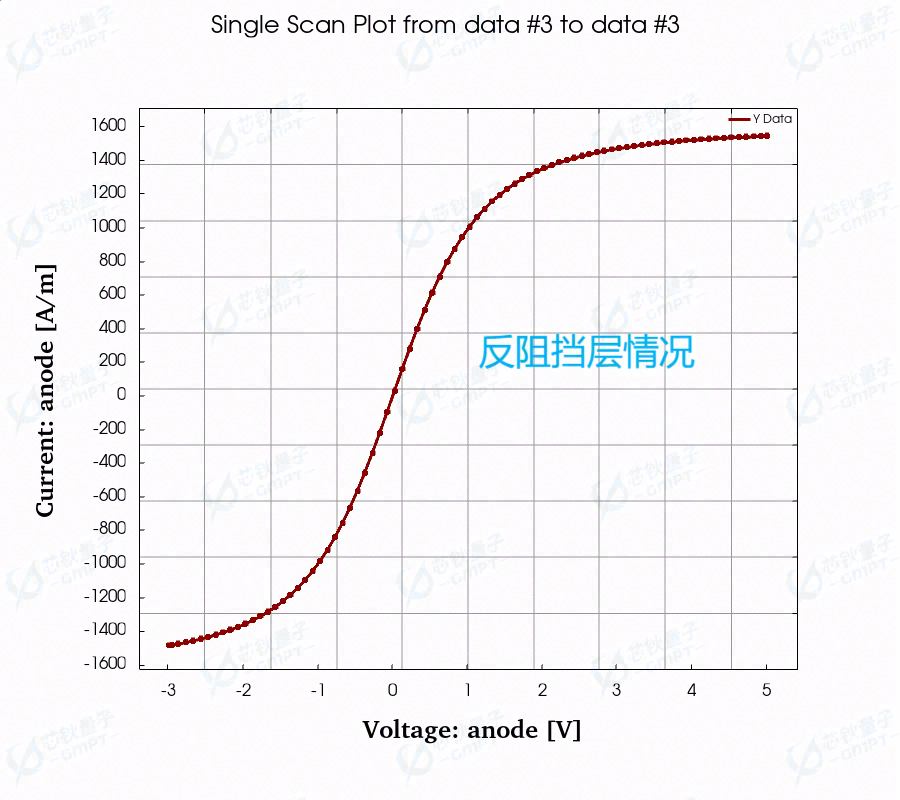
六、总结
Nuwa TCAD仿真工具对金属-半导体接触(MS)的仿真结果符合物理特性:
1.对于一块n掺杂的半导体,平衡态时,考虑金属功函数和半导体的差值,半导体能带在交界面处附近有一定弯曲,当金属功函数较大时,半导体能带向上弯曲,形成阻挡层;金属功函数较小时,半导体能带向下弯曲,形成反阻挡层。
2.电流电压特性方面,阻挡层体现整流特性,反阻挡层体现欧姆特性。