使用NUWA TCAD软件仿真GaN基垂直腔面发射激光器(VCSEL)
GMPT, 2025/01/21
氮化镓(GaN)基垂直腔面发射激光器(VCSEL)由于具有低阈值电流、单模输出、低发散角、易于阵列集成和高频特性而受到人们的广泛关注。这些特性使得GaN基VCSEL在光存储、激光显示、激光照明、可见光通信等领域有巨大的应用前景。
(In/Al)GaN材料内部存在较强的极化效应,影响能带结构与载流子分布,通过对器件结构进行模拟,可以了解器件内部的载流子输运行为。本文将基于Nuwa TCAD软件对GaN基VCSEL进行相关仿真和设计,并展示软件仿真结果。
一、研究背景
GaN基VCSEL凭借其高功率密度、窄光谱和短波长特性,广泛应用于光通信、显示技术、传感与消费电子等领域。在光通信中,GaN VCSEL可用于高速可见光通信(LiFi)和短距离光互连,具有低功耗、高带宽的特点和抗电磁干扰能力;在显示领域,其蓝绿光波段支持微型投影仪和AR/VR设备的高亮度、全彩化显示,还可用于激光电视、汽车激光大灯等;此外,在生物传感(如血氧检测)、激光雷达(LiDAR)及工业加工(高精度微纳加工)中也具有重要应用价值。未来,随着量子技术和硅光集成的进步,GaN基VCSEL在冷原子钟、量子通信等前沿领域也具有具有巨大的潜力。
GaN基VCSEL的核心参数指标主要包括光学性能(如波长稳定性、单模特性、光束质量、输出功率等)、电学性能(阈值电流、斜率效率)和动态性能(调制带宽、响应时间)等。目前,氮化镓基VCSEL的输出功率还在毫瓦的量级,可通过阵列的形式实现较大功率的输出;相比于传统的边发射激光器,VCSEL更容易实现单模输出,且具有更高的调制带宽。在器件的可靠性方面,需要满足高温工作、长寿命及低热阻等要求,同时偏振稳定性和晶圆级集成兼容性也是关键。未来技术发展将聚焦更高功率、更低阈值、更高调制带宽和更优可靠性,以推动其在消费电子、显示和工业激光等领域的规模化应用。
二、器件结构

图1. InGaN/GaN VCSEL器件结构示意图
本项工作中,基于InGaN/GaN量子阱的VCSEL器件结构设计如图1所示。上下DBR分别采用了8对和12对介质膜作为反射镜,反射率分别达到99.75%和99.99%。上下DBR之间的谐振腔由GaN材料组成,从上到下依次包括:掺杂浓度为的n型GaN、3对不掺杂的量子阱有源区、掺杂浓度为的20 nm厚度的p型电子阻挡层(EBL)、掺杂浓度为的p型GaN。量子阱和量子垒的厚度分别为3 nm和8 nm。采用氧化硅作为限制层,形成半径为4 um的电流注入孔径;采用ITO作为电流扩展层。(In/Al)GaN材料的带阶设置为0.6,极化率为0.4。
三、物理模型设置
3.1 泊松方程
3.2 电流连续性方程
3.3 SRH复合与俄歇复合
3.4 低场和高场迁移率模型
低场迁移率模型:
高场迁移率模型:
3.5 侧模和纵模计算模型
侧模计算模型:
采用有效折射率法(EIM)模型求解VCSEL的侧向光学模式,其核心思想是将复杂的三维波导问题简化为两个一维问题,从而降低计算复杂度,同时保持较高的准确性,适用于复杂结构VCSEL,如氧化孔径VCSEL。解如下的光学方程:
纵模计算模型:
采用2×2转移矩阵方法求解纵向模式
单层内传输矩阵元:
界面间传输矩阵元:
界面处反射及透射系数:
四、结果与讨论
4.1 激光器件的PIV特性

图2. (a)器件的电压随注入电流的变化曲线;(b)激光输出功率随注入电流的变化曲线
激光器的PIV曲线是衡量器件性能的重要参考。激光器在激射之前,特性与发光二极管类似,均具有整流特性,从图2(a)中可以看出激光器的开启电压大约在3.2 V。当器件开启之后,电流迅速增加,随着能带的弯曲,在有源区形成粒子数反转,增益大于损耗,并达到激射阈值。从图2(b)中可以看出,激光器的阈值电流约为1.5 mA,电光转换效率为0.43 W/A,可见激光器件具有良好的输出特性。
4.2 能带特性
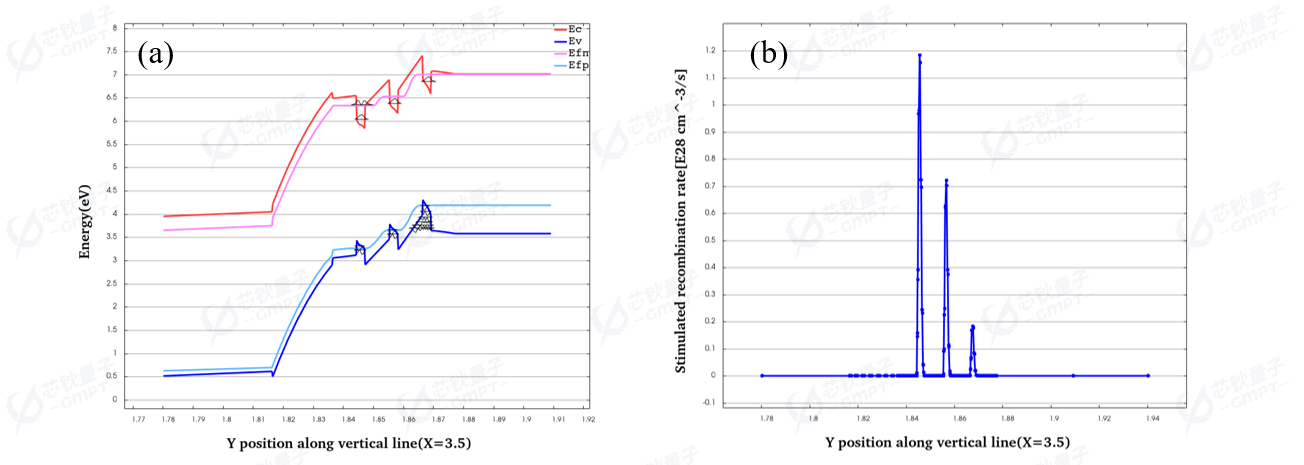
图3. (a)器件量子阱附近纵向的能带图;(b)三个量子阱中受激辐射复合速率()。图中从左到右依次为p型区、量子阱有源区和n型区
在此项工作中,截取器件量子阱区域的纵向能带分布来查看器件特性。如图3(a)所示,从左到右的几个区域依次为p型GaN、p型电子阻挡层、量子阱有源区,和n型GaN。在量子阱中存在自发极化和压电极化,在注入电流的作用下形成了能带弯曲,此时电子的费米能级已经进入了导带,达成粒子数反转的条件,在量子阱中形成增益区,实现光子数的放大。图(b)所示为三个量子阱中的受激辐射复合速率(),其值大于0说明在阱中实现了激射。此外,发现从p型到n型量子阱中的依次减小,这主要是因为空穴的迁移能力相比于电子要弱很多,因此空穴会主要分布在靠近p型的量子阱中,导致靠近p型的量子阱更容易实现粒子数反转和激射。
4.3 光场分布

图4. 激光器中光场的(a)二维分布图;(b)一维纵向分布;(c)一维横向分布。图中(b)和(c)为图(a)中箭头所示位置和方向的光场分布曲线。
激光器内部的光场分布如图4(a)所示。在垂直腔面发射激光器中,需要将量子阱有源区置于驻波波腹位置,以实现载流子和光场的最大耦合。图4(b)为有源区附近的光场纵向分布曲线,光场强度在3个量子阱的位置出现了最大值,表明与量子阱实现了良好的耦合,有助于提高光限制因子,改善激光器的输出特性。图4(c)为光场的横向分布曲线,呈现出高斯分布,横向的光场限制主要依靠氧化硅限制层产生的增益波导实现。
4.4 载流子分布与泄露
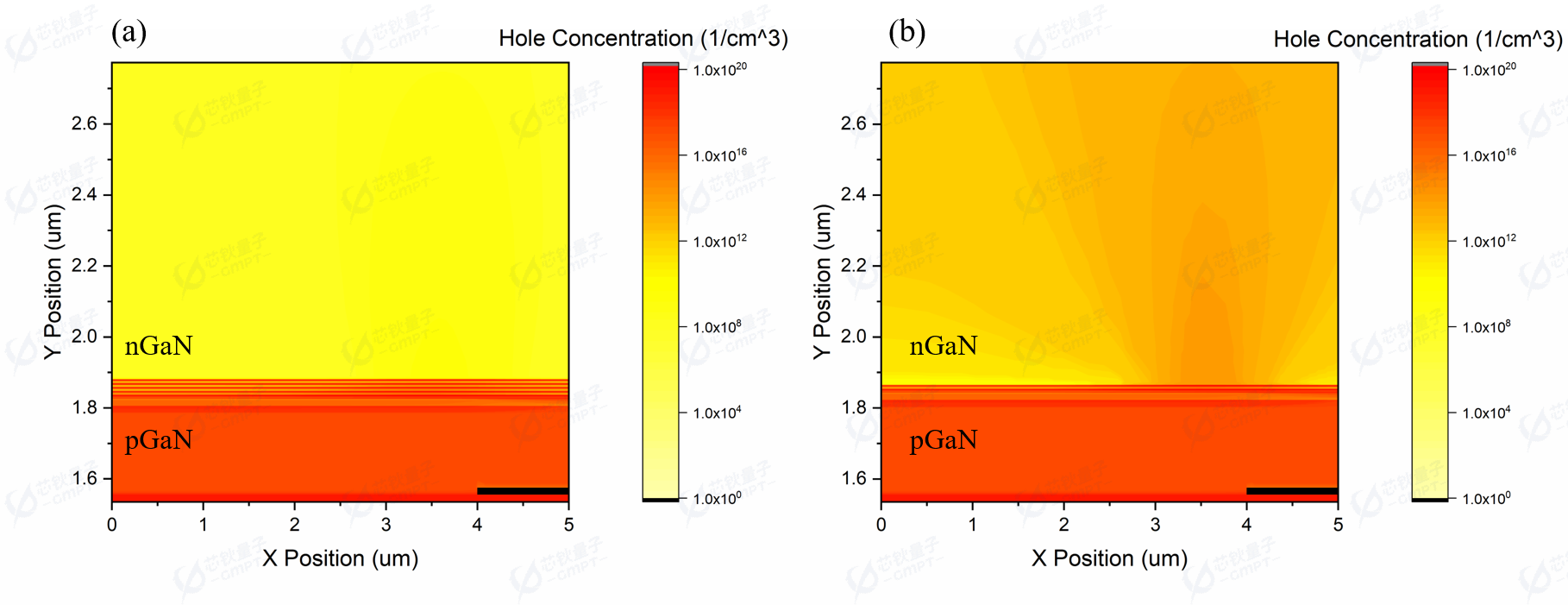
图5. 空穴浓度的二维分布图:(a)多阱结构;(b)少阱结构。
器件中的空穴分布和输运特性会直接影响到激光器的输出特性。我们希望空穴向量子阱中有较大的注入效率,同时能减少空穴向n型区域的泄露,从而提高电光转换效率,降低漏电流。图5(a)和(b)分别为采用多个和2个量子阱作为有源区的器件中空穴的二维分布图。在两个图中,空穴都主要分布在p型和量子阱区域中;然而,采用少阱会造成空穴向n型区域泄露的增加,如图(b)所示,需要被尽量避免。
四、总结
本文对GaN基VCSEL器件进行了仿真和设计,介绍了仿真中引用的物理模型的公式和参数,并展示了器件的仿真结果,包括激光器的P-I-V曲线、能带图、受激辐射复合速率分布、光场特性、空穴分布和泄露。通过Nuwa TCAD软件得到的仿真结果,本文进一步分析了器件内部机理,包括能带分布、载流子输运、光场耦合等,为GaN VCSEL器件结构分析和器件性能提升提供了思路。
本文及案例由中国科学院半导体所集成光电子国家重点实验王亚晨博士撰写和制作,在此表示感谢!