使用Nuwa TCAD软件仿真和设计SiC SBD器件
GMPT, 2024/05/17
摘要: 碳化硅(SiC)半导体材料是目前电力电子领域发展最快的半导体材料之一。其中4H-SiC由于其较宽的能带间隙(约3.2 eV)、较高的击穿电压以及优秀的电子迁移率,在高功率、高频率的电子器件应用中展现出卓越性能。
SiC半导体功率器件主要包括两大类:二级管类和晶体管类,其中SiC肖特基势垒二极管(SiC SBD),具有高反向恢复速度、高耐压、高频等特点,广泛应用于空调、电源、光伏发电系统中的功率调节器、电动汽车的快速充电器等的功率因数校正电路(PFC电路)和整流桥电路中。本文将基于Nuwa TCAD软件对4H-SiC 基的SBD进行相关仿真和设计,并展示软件仿真结果。
一、器件结构

图1. SiC SBD器件结构示意图
在此项工作中,4H-SiC基SBD器件结构设计如图1所示。其中,漂移区厚度设置为4μm,掺杂水平设置在1×1016cm−3,重掺杂衬底区厚度设置为2μm,掺杂水平设置在5×1019cm−3,器件整体宽度设定为2.5μm,阳极肖特基功函数设定为5.15 eV。
二、物理模型设置
2.1 热电子发射模型
J=[A∗T2exp(−kTqϕB)][exp(kTqV)−1]
2.2 连续性方程
∇⋅Jn−j∑Rntj−Rsp−Rst−Rau+Gopt(t)=∂t∂n+ND∂t∂fD
∇⋅Jp+j∑Rptj+Rsp+Rst+Rau−Gopt(t)=−∂t∂p+NA∂t∂fA
2.3 泊松方程
−∇⋅(qϵ0ϵdc∇V)=−n+p+ND(1−fD)−NAfA+j∑Ntj(δj−ftj)
2.4 低场和高场迁移率模型
低场迁移率模型
μ0n=μ1n+1+(NrnND+NA+∑jNtj)αn(μ2n−μ1n)
μ0p=μ1p+1+(NrpND+NA+∑jNtj)αp(μ2p−μ1p)
高场迁移率模型(Canali Model)
μn=(1+(μ0nF/vsn)βn)1/βnμ0n
μp=(1+(μ0pF/vsp)βp)1/βpμ0p
2.5 界面缺陷模型
Exponential tail Model
DOS(E)=EtailNtrape[−Etail(E−E0)]
Gaussian Model
DOS(E)=2πσNtrape[−2σ2(E−E0)2]
2.6 体缺陷模型
Shockley-Read-Hall Model
Rntj=cnjnNtj(1−ftj)−cnjn1jNtjftj
Rptj=cpjpNtjftj−cpjp1jNtj(1−ftj)
Ntj∂t∂ftj=Rntj−Rptj
cnj=σnjvn=σnjπmn8kT;cpj=σpjvp=σpjπmp8kT
τnj1=cnjNtj;τnj1=cnjNtj
Gaussian Model
DOS(E)=2πσNtrape[−2σ2(E−E0)2]
2.7 碰撞电离模型
Chynoweth Model
αn=αn∞e−(FFcn)κn
αp=αp∞e−(Fcp)κp
碰撞电离参数设置
|
α∞(1/m) |
Fc(V/m) |
κ |
Feild range to (V/m) |
| Electron |
2×1010 |
3.6×1010 |
1 |
∞ |
| Hole |
1.34×1010 |
2.03×109 |
1 |
∞ |
三、结果与讨论

图2. 器件纵切能带图
在此项工作中,截取器件纵向能带分布,如图2所示。X轴起始点为阴极接触面。相比于实验值1.55 eV,器件表面肖特基接触势垒观测值为1.548 eV,与实验值基本相符。另外,在漂移层与衬底界面附近,存在一个由于浓度差异造成的很小的势垒,其势垒大小为0.191 eV(漂移扩散过程形成的)。
3.1 正向输出特性
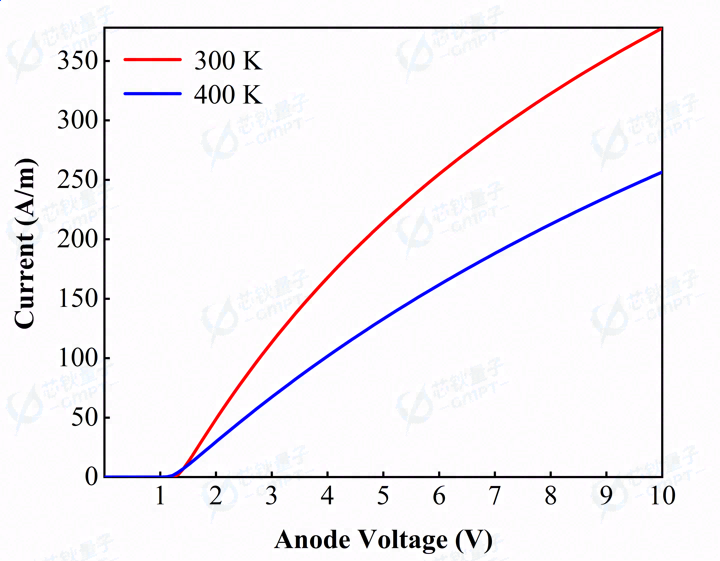
图3. 器件正向I-V特性曲线
在本工作中,器件掺杂为n型,器件导通时以电子电流为主,器件整体电流几乎全为电子电流贡献,空穴电流水平几乎为零,空穴基本不参与输运过程,器件本身为单极型器件。观察图3,300 K温度条件下,二极管的开启电压为1.221 V(I=0.113 A/m),电压为10 V时,器件的电流面密度约为377 A/m;当温度提升至400 K时,二极管的开启电压为1.121 V(I=0.187 A/m),电压为10 V时,器件的电流面密度约为257 A/m。
在器件正向工作时,当器件外置正向偏置小于开启电压,由于温度升高,带来更强的热电子发射过程,所以器件开启电压随温度升高而减小。
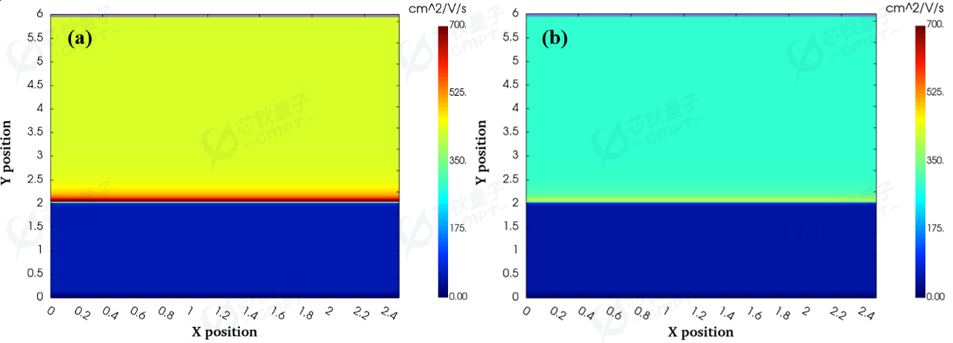
图4. 温度为(a)300 K和(b)400 K的二维电子迁移率分布
当器件导通后,外部载流子注入,由于300 K到400 K阶段,杂质已经全部电离,而本征激发可以忽略,载流子浓度不随温度变化,因此晶格振动散射成为主要矛盾,温度的升高增强了晶格振动散射概率,导致载流子平均自由时间减小,如公式(1)所示
τs∝T−3/2(1)
由公式(2)可知,载流子迁移率随温度的上升而下降(如图4所示),进而造成器件到达开启电压后的正向电流密度J减小。如公式(3)和公式(4)所示
μ=m∗qτ(2)
σ=nqμ(3)
J=σ∣E∣(4)
3.2 反向阻断特性
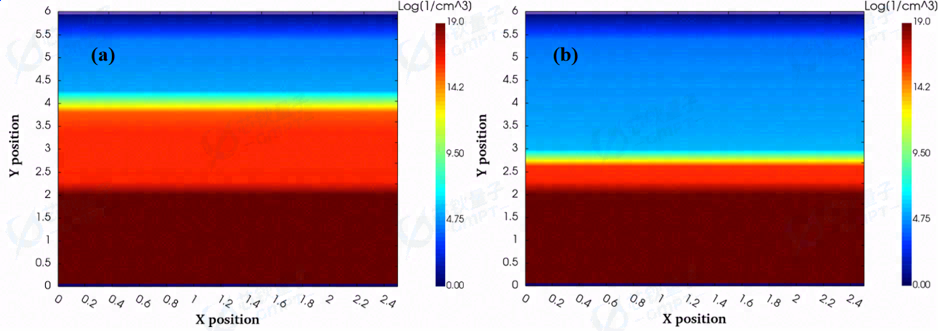
图5. 器件反向偏置电压为(a)50 V和(b)100V的载流子浓度分布
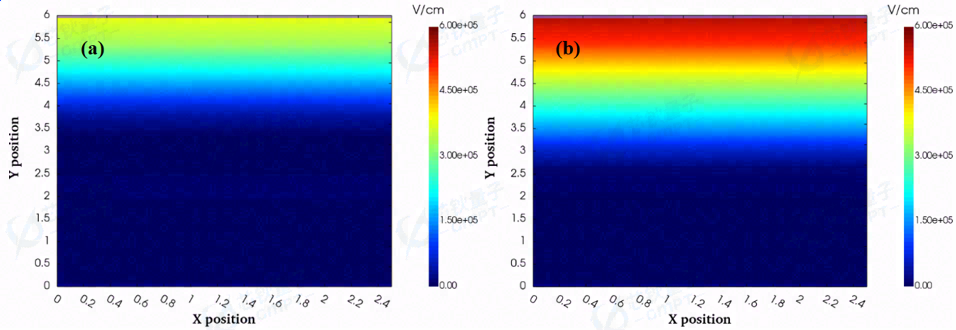
图6. 器件反向偏置电压为(a)50 V和(b)100V的场强分布
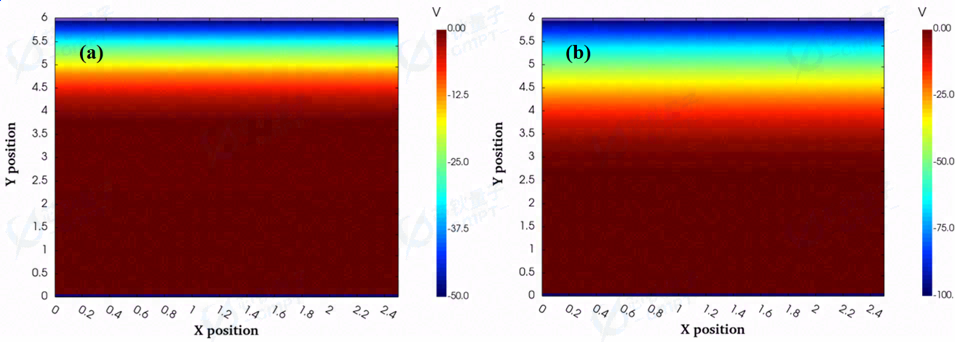
图7. 器件反向偏置电压为(a)50 V和(b)100V的电势分布
50 V和100 V情况下的载流子浓度、电场、电势分布图如图5、图6、图7所示。当器件呈反向偏置状态时,耗尽区作为承载场强的主要区域,受反向电压影响,表面肖特基接触形成的耗尽区不断扩大,电子被不断耗尽,电势与耗尽区承担场强不断上升且向器件内部延伸。

图8. 温度为(a)300 K和(b)400 K的反向击穿曲线
在此次仿真工作中,同样计算并分析不同温度(300 K和400 K)下的器件关态特性,反向击穿曲线如图8所示。根据前面提到碰撞电离模型,本工作中设计的器件的击穿电压在940 V附近,当温度提升至400 K时,器件的击穿电压在1110 V附近。
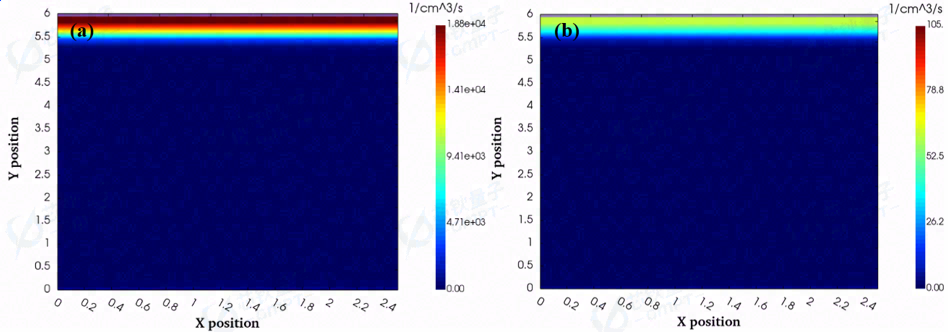
图9. 反向偏置100V器件在(a)300 K和(b)400 K温度下的碰撞电离率二维分布
由于温度提高导致的本征载流子浓度提高,器件内部的迁移率下降,影响了碰撞电离过程中的平均自由程,导致碰撞电离几率下降(如图9所示),器件击穿电压升高。
3.3 电容-频率特性
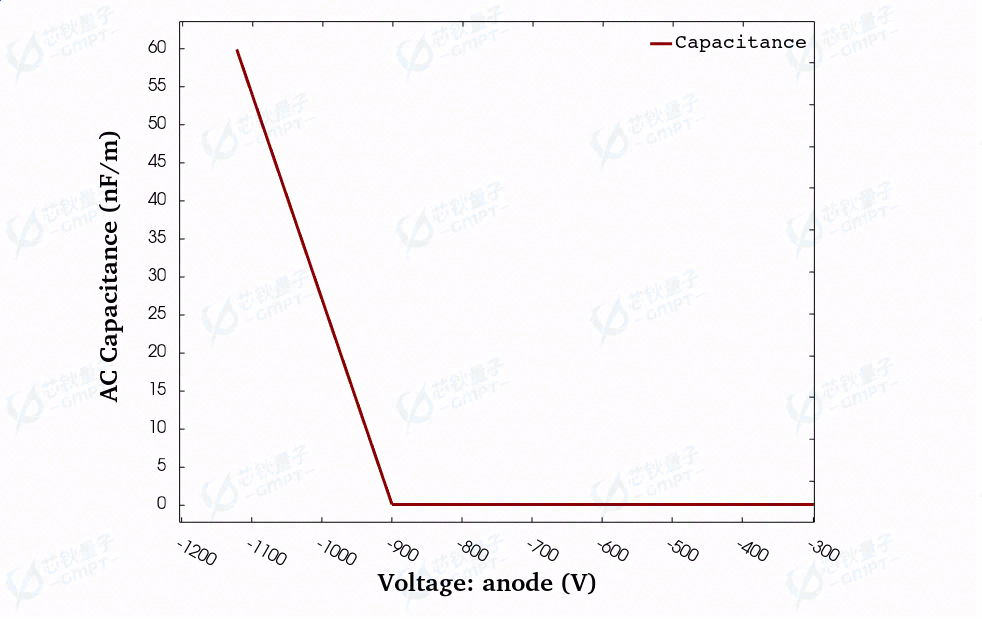
图10. 器件反向C-V特性曲线
图10展示了器件处于关态时的C-V特性曲线,在器件尚未击穿时,器件不断被耗尽,器件本身电荷不会增加,当接近击穿电压时(900 V以上),由于碰撞电离率不断上升,器件内部电荷不断增加,从而出现电容随着电压增大而不断增大的现象。
3.4 反向恢复特性
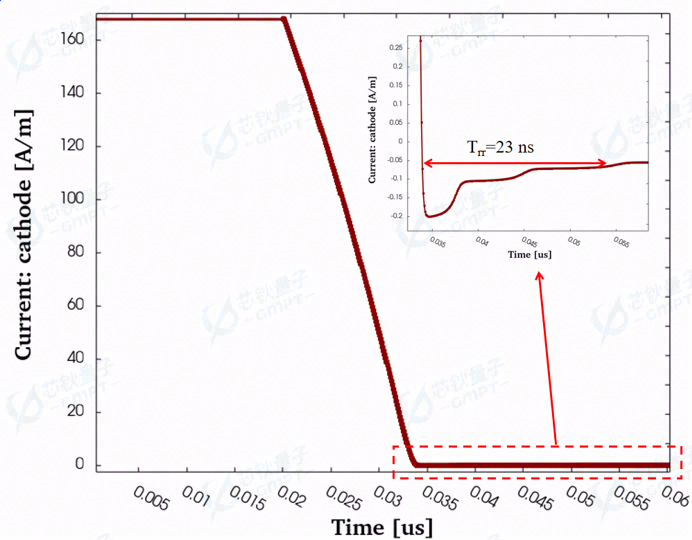
图11. 反向恢复特性曲线
对于当前功率电子应用市场,SiC SBD器件主要应用于高频,高功率环境中,因此在高速的开关过程中,优异的反向恢复特性可以减小器件功耗,提高开关频率。本项工作研究了SiC SBD器件的反向恢复特性,如图11所示。观测仿真数据可知,SiC SBD展现了优异的反向恢复电流和反向恢复时间,其中反向恢复时间仅为23 ns。
四、总结
本文对SiC SBD器件进行了仿真和设计,介绍了仿真中引用的物理模型的公式和参数,并展示了器件的仿真结果,包括能带图、正向输出特性、反向阻断特性、电容-频率特性和反向恢复特性。通过Nuwa TCAD软件得到的仿真结果,本文进一步分析了器件内部机理,包括能带分布、载流子迁移和晶格振动等,为SiC SBD器件结构分析和器件性能提升提供了思路。